IC package
封装技术发展路径:

裸片贴装
传统方式,晶圆切割后,粘在基板上,进行引线键合。
倒片封装
晶圆倒扣在基板上,用金属小球连接
缩短了互联距离、减小了阻抗、连接密度更大、封装更紧凑、尺寸更小
RDL重布线层技术
RDL (redistribution layer) 将IO触点从边缘延伸到芯片表面,此技术可应用于倒片封装。
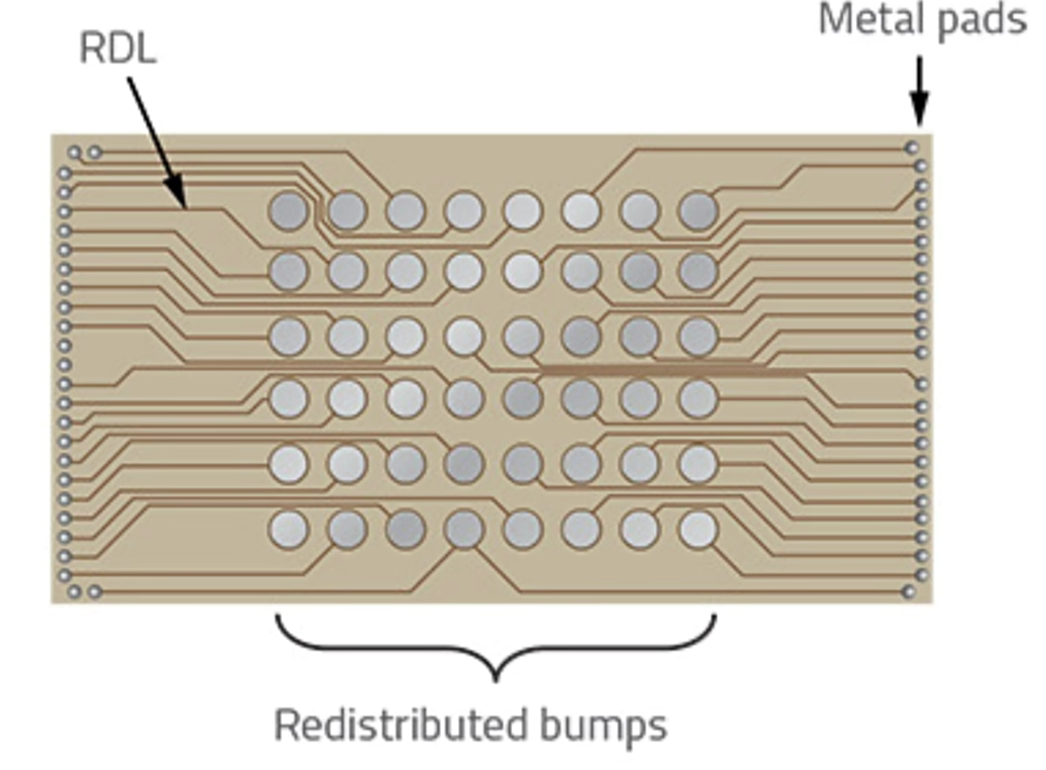
晶圆级封装
这个也要基于RDL技术
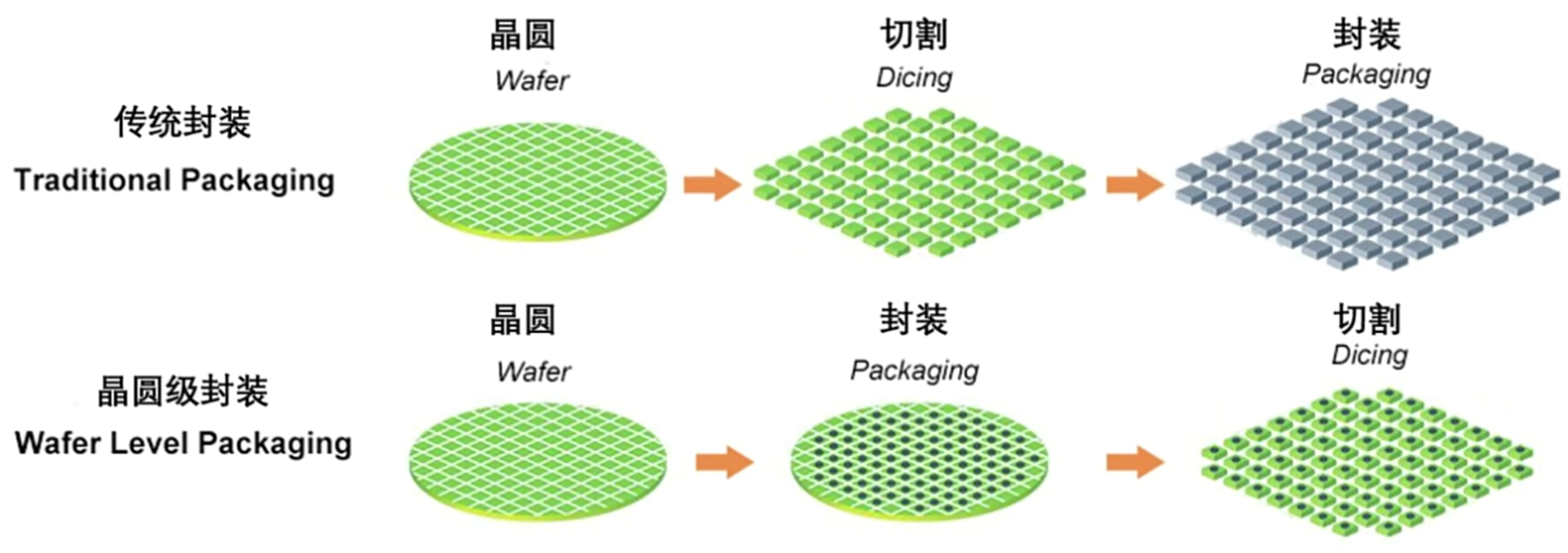
扇入型封装
切割之后出来就是成品,成品的尺寸和裸片几乎相同
扇出型封装
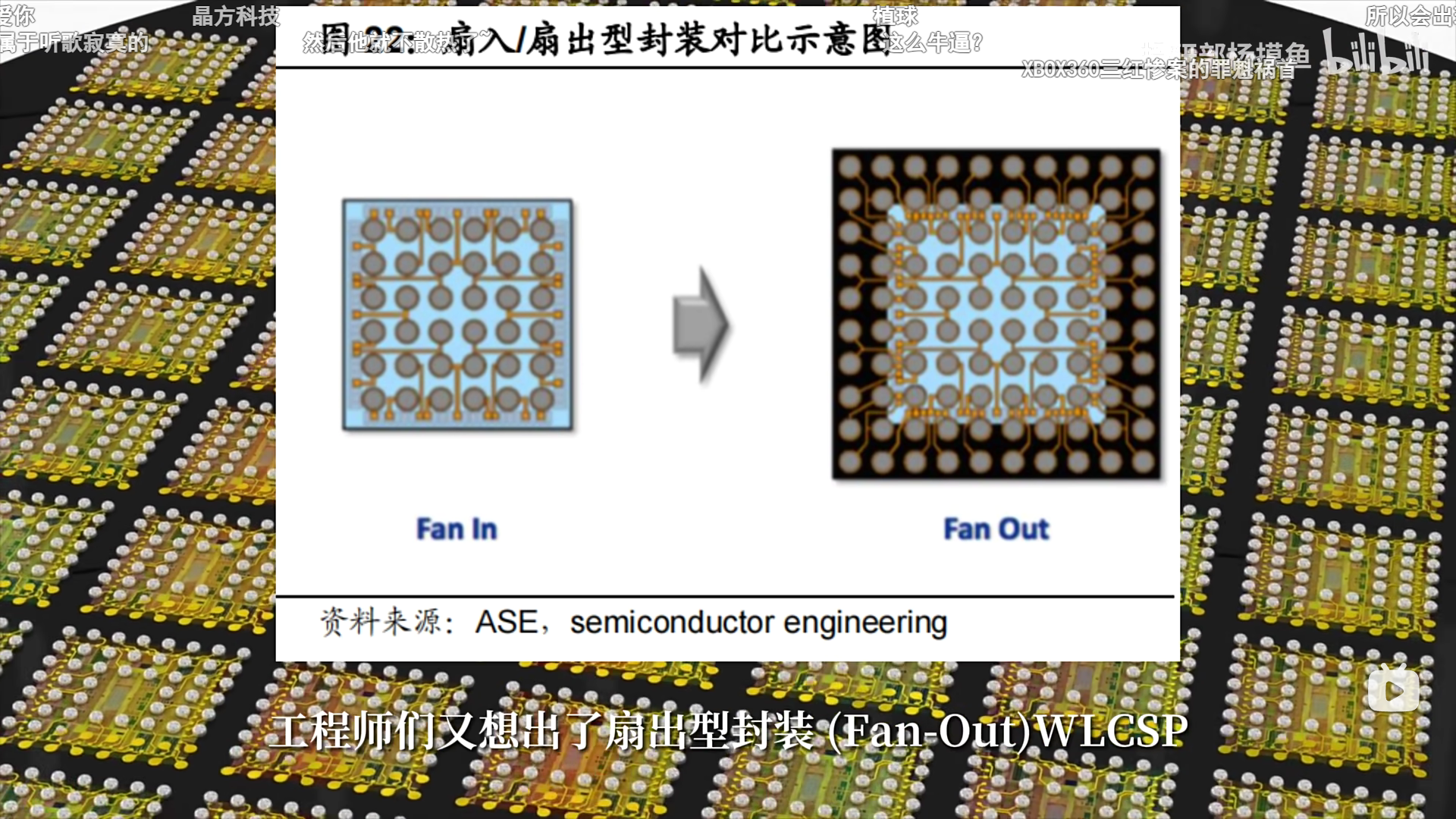
相比扇入型,外围多加了一圈保护壳,增加了触点
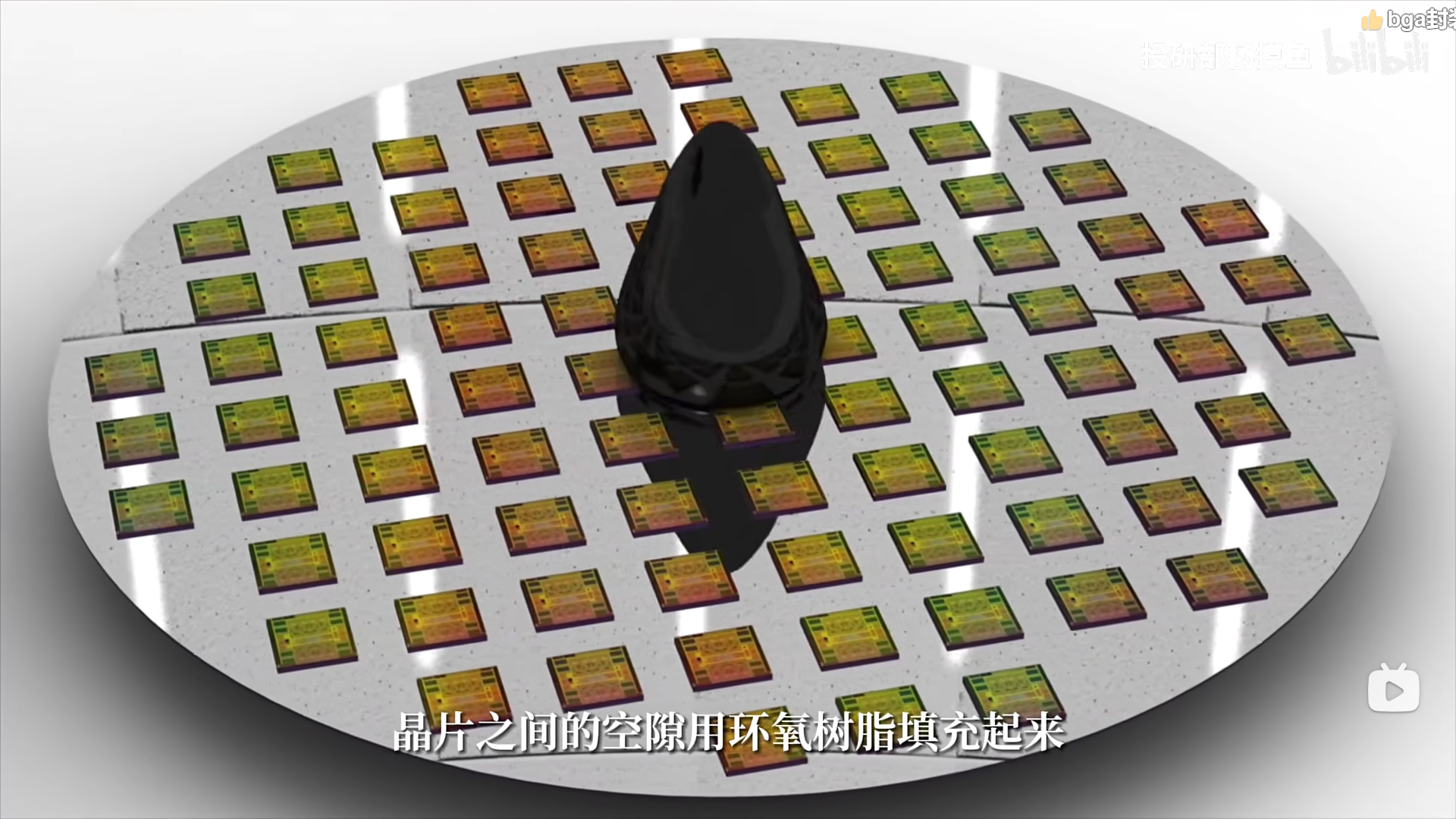
2.5D/3D封装
考虑多个芯片协同封装
传输路径短,减小了延迟、功耗

2.5D封装
将两块芯片放在同一块硅中介层上,再把硅中介层安装在基板上。
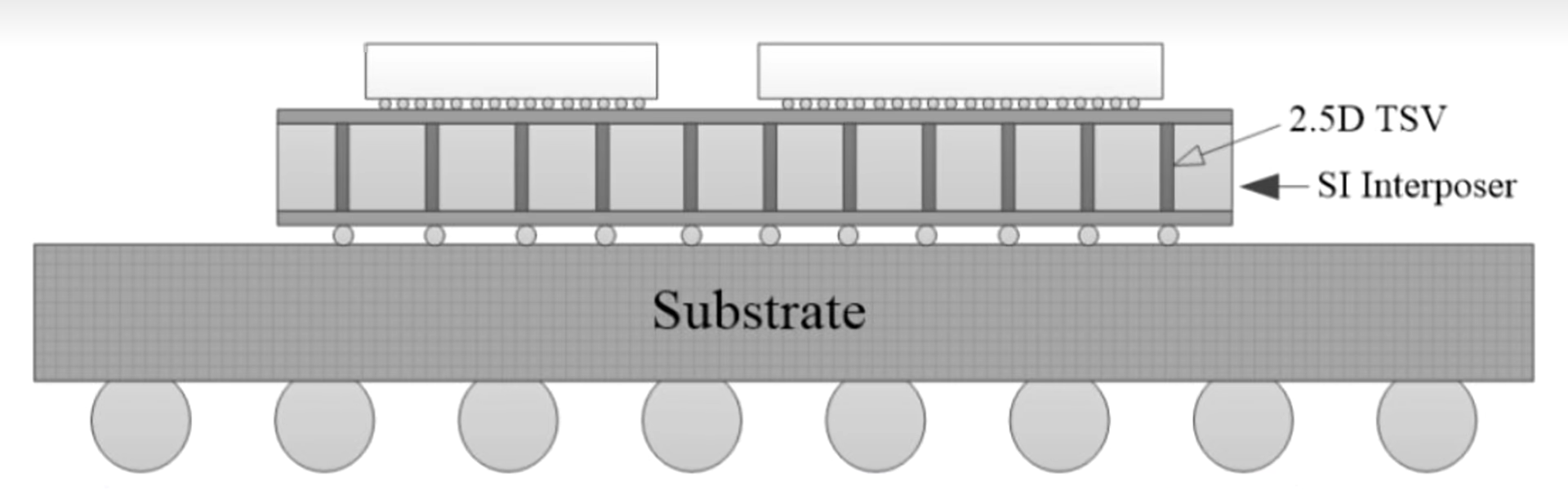
3D封装
相比于2.5D,没有了Si interposer,直接进行Die堆叠。
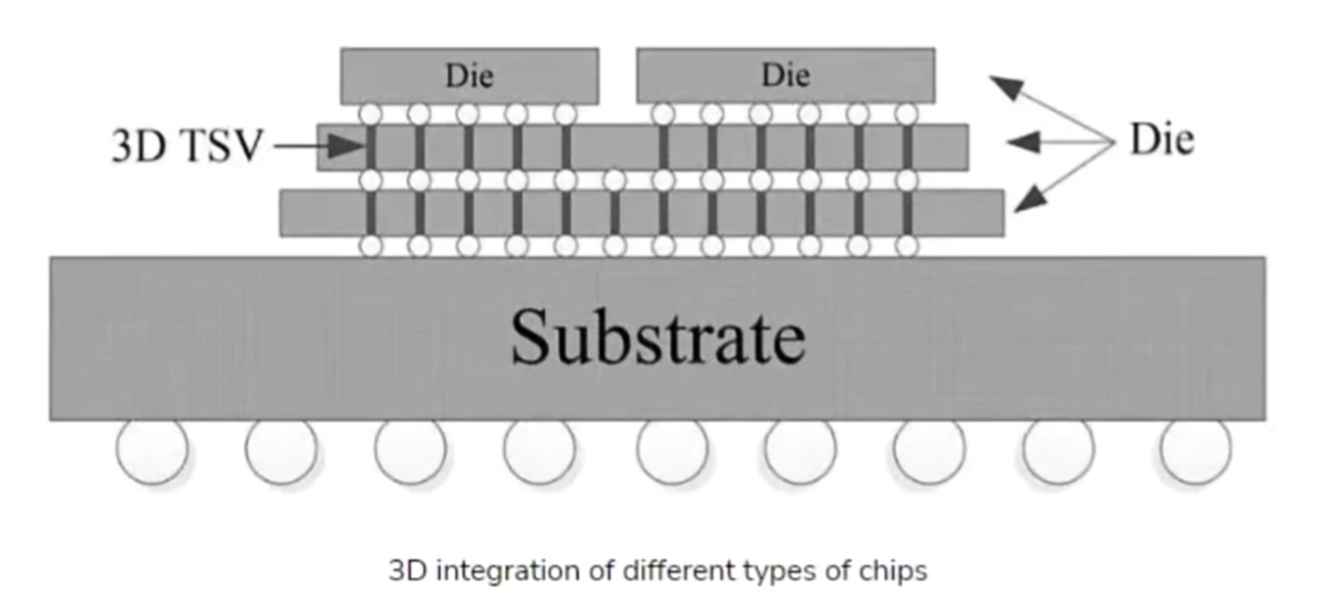
2.5D/3D封装,其关键技术是TSV (Trough Silicon Via) 硅通孔技术
chiplet封装

chiplet相当于把SoC这一整个复杂大系统拆分成几个小芯片
- 良率高了,成本低了
- 技术难度低了,开发周期短了
- 可复用了,更灵活了
- 面积消耗多一些,而性能与SoC旗鼓相当
参考链接
全网最简单清晰!15分钟彻底讲清楚芯片封装技术!硬核剖析先进封装,3D封装、TSV、Chiplet一网打尽!【深度报告】
IC package
http://example.com/2024/07/24/IC-package/